| ■ | 豊富な最先端技術の開発経験に基づく超高速・広帯域メモリ設計技術を用いた4、8、12、16積層/パッケージ製品開発 |
| ① JEDEC標準DRAM | :LP3、LP4、LP5、DDR4、DDR5、HBM |
| ② カスタムメモリ | :ワイドI/O(×64以上)、多チャネル(4、8)/パッケージ |
| ③ 積層メモリ | :Wafer on Wafer |
| ④ 2.5、3D実装 | |
| ⑤ 超高速、低消費電力パッケージ | |
| ■ | 豊富な最先端技術の開発経験に基づく超高速・広帯域メモリ設計技術を用いた4、8、12、16積層/パッケージ製品開発 |
| ① JEDEC標準DRAM | :LP3、LP4、LP5、DDR4、DDR5、HBM |
| ② カスタムメモリ | :ワイドI/O(×64以上)、多チャネル(4、8)/パッケージ |
| ③ 積層メモリ | :Wafer on Wafer |
| ④ 2.5、3D実装 | |
| ⑤ 超高速、低消費電力パッケージ | |
| ■ | 独自開発事例 |
| プロジェクト | 技術 | 特徴 | 開発状況 |
|---|---|---|---|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
| ■ | 設計受託 |
カスタムインタフェースを含む各種メモリ(DRAM/SRAM/MRAM)の開発において20件以上の設計実績があります。
| ■ | 特許実績(登録済み件数) |
2022年12月現在 日本:22 米国:13 中国:8 合計:43件
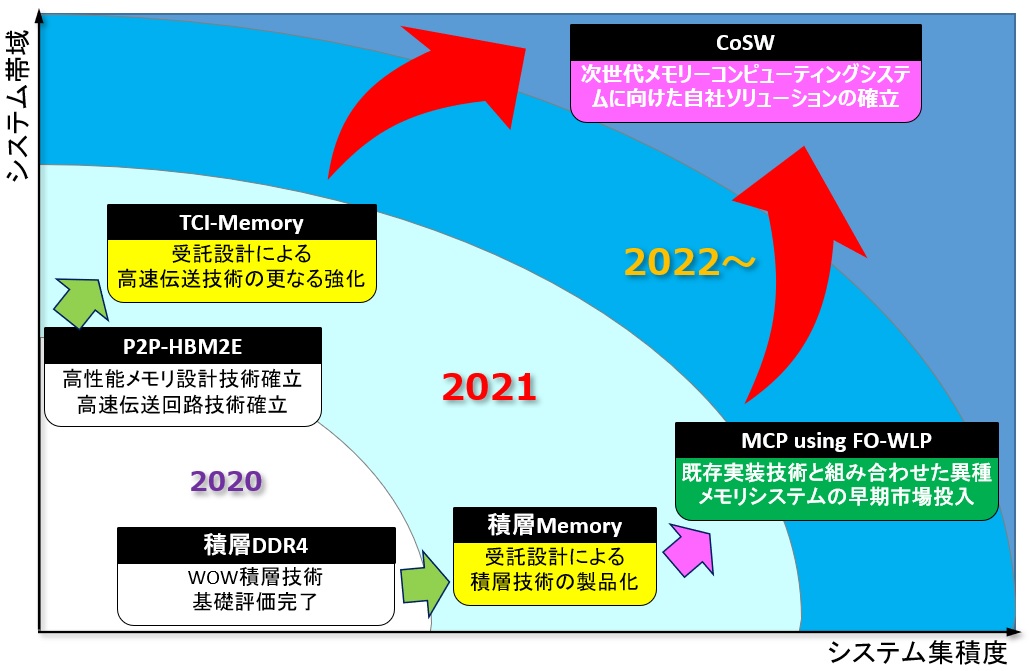
| P2P | :Pad to Pad interconnect | TCI | :ThruChip Interface |
| FO-WLP | :Fan Out Wafer Level Package | MCP | :Multi Chip Package |
| CoSW | :Chip on Stacked Wafer | WOW | :Wafer on Wafer |
Copyright © 2026 UltraMemory Inc. All Rights Reserved.